技术-薄膜
薄膜沉积技术可以分为化学气相沉积(CVD)和物理气相沉积(PVD)。对于 CVD 工
艺,这包括原子层沉积(ALD)和等离子体增强化学气相沉积(PECVD)。PVD 沉积技术包
括溅射,电子束和热蒸发。CVD 工艺包括使用等离子体将源材料与一种或多种挥发性前驱
物混合以化学相互作用并使源材料分解。该工艺使用较高压力的热量,从而产生了更可再
现的薄膜,其中薄膜厚度可以通过时间/功率来控制。这些薄膜的化学计量性更高,密度更
高,并且能够生长更高品质的绝缘体薄膜。PVD 处理使用通过某种电能气化的固体前驱体
金属。然后将气化的原子转移到衬底上。该过程使用石英晶体速率监控器控制膜的速率和
厚度来管理厚度。抽气室至较低的液位将减少背景气体与预期的制膜工艺发生化学反应。
原子层沉积(ALD)
原子层沉积是一种化学气相沉积技术,可以在原子层规模上进行表面控制,均匀且优
异的保形膜生长。表面控制的薄膜生长是 ALD 的独特功能,它基于气相前体分子与活性表
面物质之间的顺序性,自限性化学反应。在典型的 ALD 过程中,至少两个气相前体被顺序
地脉冲到衬底所在的反应空间中。一个示例是使用三甲基铝( TMA)加水蒸气(H2O)来
生长氧化铝(Al2O3)。一个完整的序列(或循环)由一系列脉冲和吹扫步骤组成。通过吹
扫步骤将脉冲步骤分开,以从脉冲之间的反应空间中除去任何残留的前体和 /或挥发性反应
副产物。加工的限制条件是 180°C 加热,并且每个周期的薄膜厚度只能缓慢增长 0.04nm 至
0.10nm。ALD 膜的保形度非常接近 2000:1 的长宽比,因此在特征上具有出色的台阶覆盖
率。该过程是可重复的,并且可以预期地在 10nm 的厚度下生长更薄的层。我们的薄膜包
括氧化铝(AL2O3),氧化 Ha(HfO2)和氧化钛(TiO2)。近年来,其在半导体行业中的
应 用 使 ALD 快 速 发 展 , 以 开 发 薄 的 高 K 栅 极 电 介 质 层 。 我 们 的 薄 膜 包 括 氧 化 铝
(AL2O3),氧化 Ha(HfO2)和氧化钛(TiO2)。近年来,其在半导体行业中的应用使
ALD 快速发展,以开发薄的高 K 栅极电介质层。我们的薄膜包括氧化铝(AL2O3),氧化
Ha(HfO2)和氧化钛(TiO2)。近年来,其在半导体行业中的应用使 ALD 快速发展,以开
发薄的高 K 栅极电介质层。
PECVD 膜沉积
等离子增强化学气相沉积是通过在平行电极(接地电极和射频激励电极)之间引入反
应气体来实现的过程。电极之间的电容耦合将反应气体激发到等离子体中,从而引发化学
反应并导致反应产物沉积在基板上。通常将放置在接地电极上的基板在 1 Torr 的中压下加
热 到 350℃ 。 PECVD 工 艺 提 供 了 良 好 的 功 能 覆 盖 范 围 。 我 们 的 薄 膜 包 括 二 氧 化 硅
(SiO2),氮化硅(Si3N4)和低应力氮氧化物(SiON)薄膜。PECVD 膜比 ALD 具有更大的
灵活性,并具有更高的沉积速率,从而带来了更高的产量。
当前的泄漏量 0-10v 结果:各种 50nm 介电膜类型




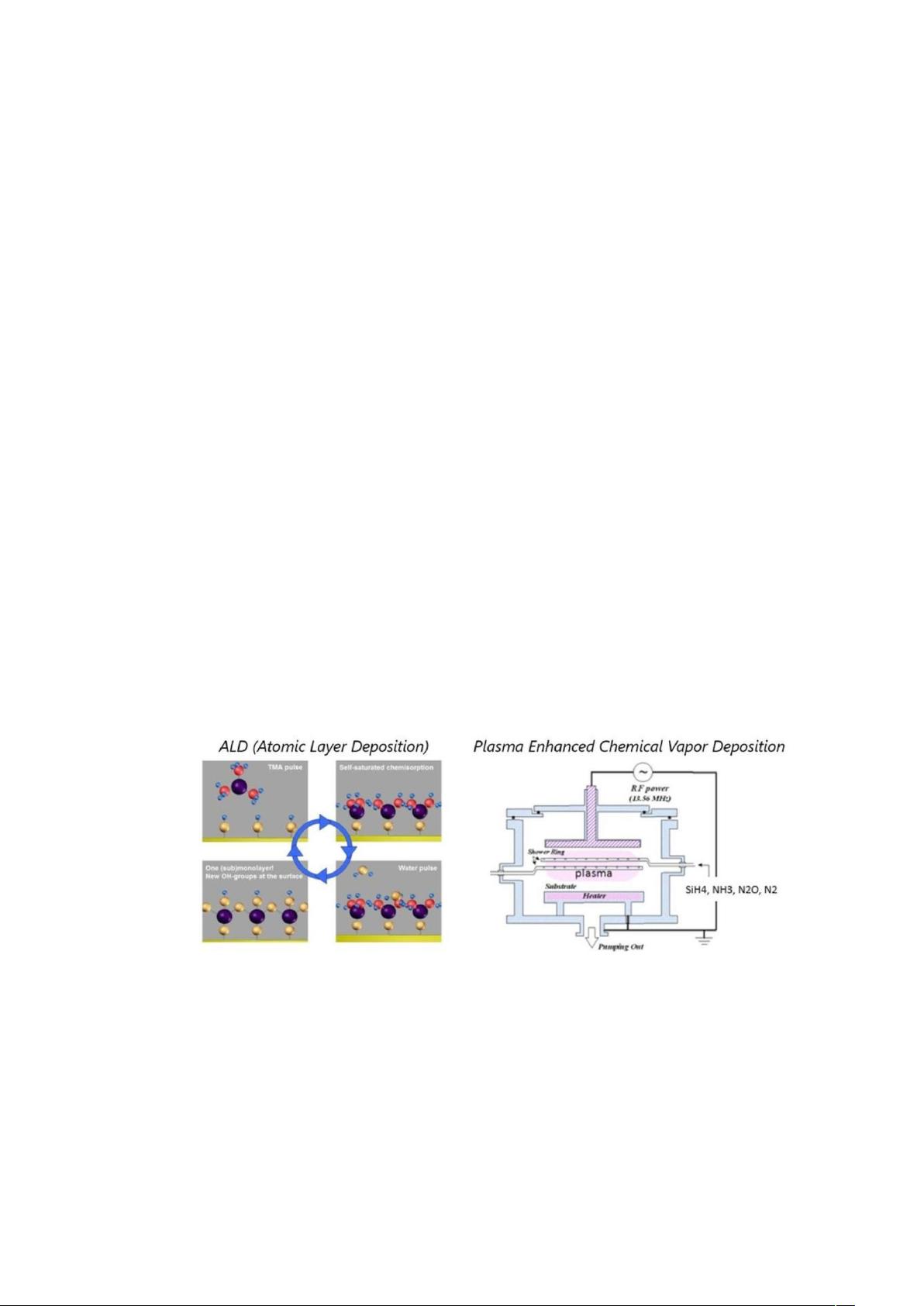









评论0