一文详解晶圆一文详解晶圆BUMP加工工艺和原理加工工艺和原理
随着现代电子装置对小型化、轻量化、高性能化、多功能化、低功耗化和低成本化方面的要求不断提高,IC芯
片的特征尺寸不断缩小,且集成规模迅速扩大,芯片封装技术也在不断革新,凸点加工工艺
(Bumpprocessflow)也因此发展起来。 Bumpprocess分为三种:BOPCOA、BOAC、HOTROD,其封装
的优缺点如下表所示。 对于芯片尺寸要求没那么严格的情况,大多数产品都是采用QFN封装形式的芯片,
因其可测性和散热较好;而对于耳机、手机等小型化产品的芯片,大多采用WSCP(waferscalechippackage)
封装。同一种功能的芯片而言可以加工成不同的封装形式,仅在Bump和Asse
随着现代电子装置对小型化、轻量化、高性能化、多功能化、低功耗化和低成本化方面的要求不断提高,IC芯片的特征尺
寸不断缩小,且集成规模迅速扩大,芯片封装技术也在不断革新,凸点加工工艺(Bumpprocessflow)也因此发展起来。
Bumpprocess分为三种:BOPCOA、BOAC、HOTROD,其封装的优缺点如下表所示。
对于芯片尺寸要求没那么严格的情况,大多数产品都是采用QFN封装形式的芯片,因其可测性和散热较好;而对于耳
机、手机等小型化产品的芯片,大多采用WSCP(waferscalechippackage)封装。同一种功能的芯片而言可以加工成不同的
封装形式,仅在Bump和Assembly层面有所区别,可以理解为QFN封装在完成Bump制程后还需要打线(WireBonding)或者
引线框架(leadframe)将引脚引出, 塑封成型,而WCSP则在Bump完成Ballattach之后就是一颗完整可以交付到客户手上
的芯片了,这可以减少很多的设计开发成本。
为了更好的理解bump制程工艺,接下来简单介绍一下WCSP的工艺流程。
Bump的制程在fab之后,fab是将电路部分加工完成,一般有三层metal, 上层留有viatop,便于bump进行下一步的加
工。一般从fab过来的wafer都会有一道宏观检测,去检测是否从fab过来就有defect,类似刮伤、污染、破片之类的问题。然后
再做清除和烘烤去除wafer上的松散颗粒和有机污染物以及wafer上的水分。
完成了前序动作,才真正开始bump制程,首先在incoming的wafer上溅镀上一层薄薄的金属层,一般是3um-Tiw和2um-




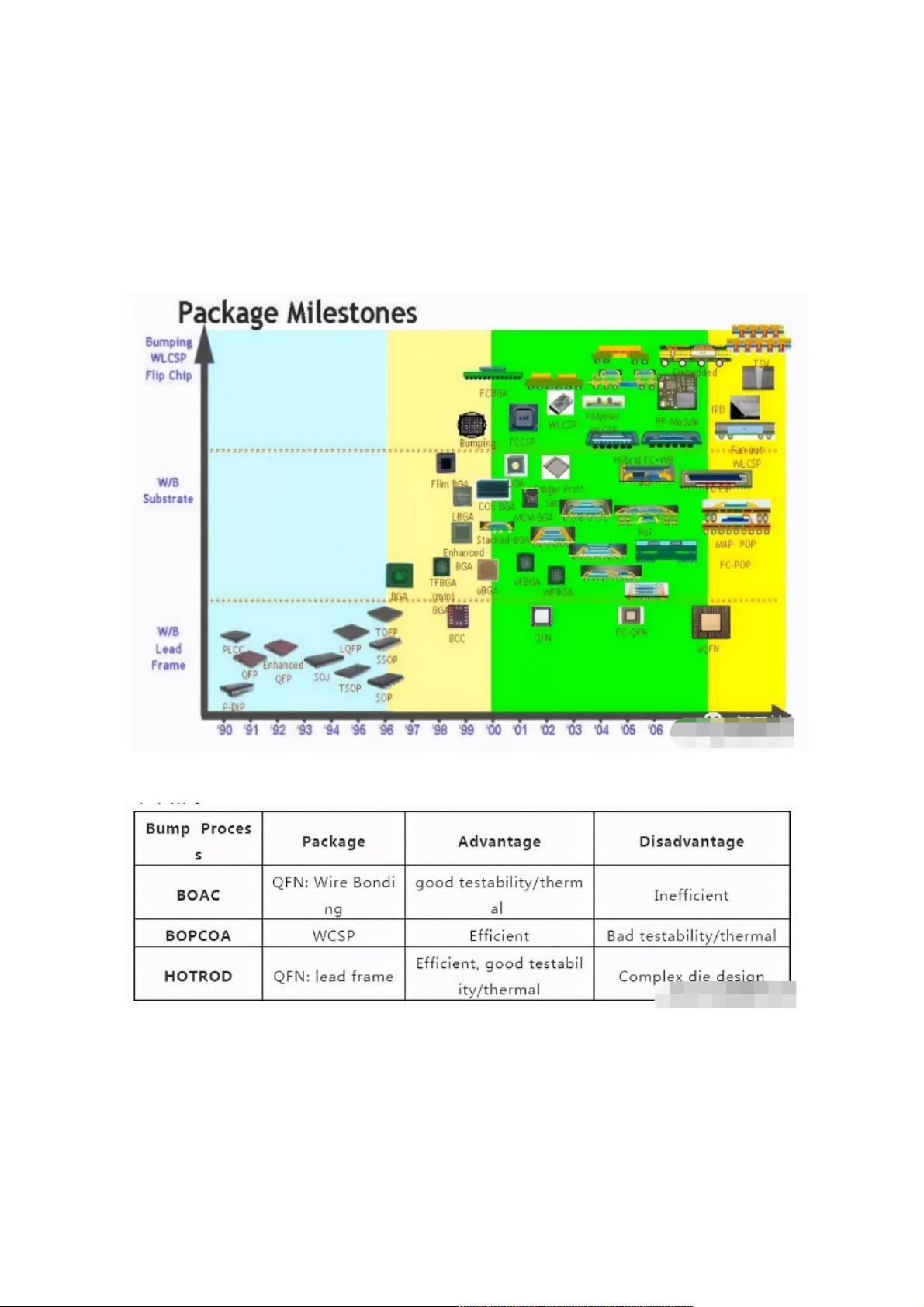









评论0